封装|封装扼制芯片制造咽喉?

文章插图
最近,供应链消息称AMD正在将其EPYC处理器价格提高10%-30%,其涨价主要影响因素是AMD依赖的晶圆代工厂与半导体封测(OAST)。由于AMD的EPYC多芯片设计可在单个封装中扩展多达9个芯片,OSAT服务明显影响其生产。
无独有偶,英特尔表示其采用Intel 7工艺制造的多芯片架构Sapphire Rapids的全面量产将会推迟到2022年第三季度。究其背后的原因,同样是封装。虽然英特尔大部分封装是在内部完成,但由于关键材料的短缺,封装依旧是其生产瓶颈。
在2022年开年,封装问题就成为了影响CPU供应的一大因素。
价值增厚的半导体封装
封装是半导体生产的流程之一,是指将通过测试的晶圆按照产品型号以及功能需求加工得到独立芯片的过程。根据Gartner统计,封装环节价值占封测比例为80-85%。
实际上,传统封装在半导体产业链中并不是一个令人注意的环节,但先进封装已经成为目前半导体产业的关键环节。
随着近几年芯片工艺不断演进,硅的工艺发展逐渐逼近物理极限,摩尔定律被反复提及。在后摩尔时代,想要晶体管想要变小变得越加困难。
而先进制程的出现,使得电子封装推动芯片高密度集成、性能提升、体积微型化和成本下降。到了现在,不再单纯一线宽距和集成度的尺寸比较,更多的是考虑如歌提升系统的性能以及如何在整个微系统上提升集成度,封装的作用越发凸显。
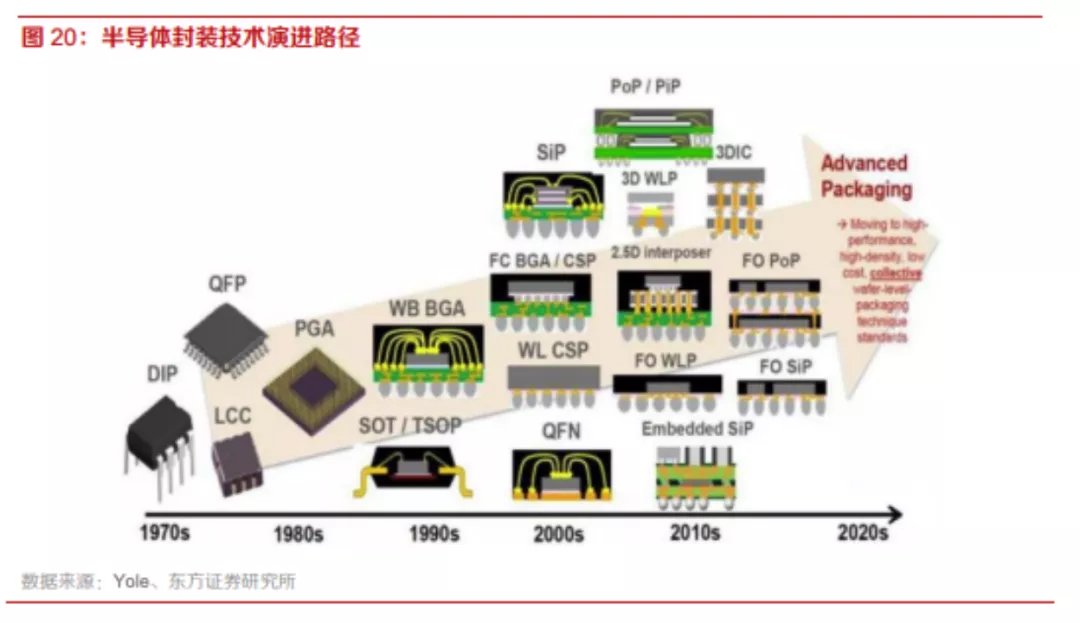
文章插图
长电科技首席执行长郑力向曾表示:“先进封装已经成为超越摩尔的关键赛道,集成电路的成品制造环节的创新能力和价值越来越强。”
目前封测行业正在从传统封装向先进封装转型。主流的先进封装包括,倒装芯片(FC--Flip Chip)、晶圆级芯片规模封装(WLCSP-Wafer Level Chip Scale Package)、扇出型芯片封装(Fan-out WLP)、系统级封装(SiP--System in a Package)、2.5D/3D封装等。
先进封装之战吹响号角
Yole的数据显示,2021年,外包半导体封装和测试(OSAT)企业将花费不低于67亿美元用于先进封装的技术研发、设备采购和基础设施建设。
但不止OAST,晶圆代工巨头台积电、IMD厂商如三星、英特尔也在切入先进制程。
这是因为,随着封装技术升级至晶圆级别,具有工艺积累的厂商需要给客户提供更加完整的解决方案。例如,台积电需要满足苹果对于产品性能升级需求以及快速交付产品,同样提供先进封装的业务。

文章插图
台积电、intel等布局先进封装
在这场先进制程的竞赛中,最抢眼的有5家企业,分别是日月光、台积电、英特尔、Amkor和江苏长电(JCET)。
早在2012年,已经成为晶圆代工龙头的台积电就已经开启了在封装领域的布局。在2012年,台积电开始与全球FPGA大厂Altera公司合作先进封装技术。
在2021年的Hot Chips大会上,台积电展示了其chiplet和3D封装技术。台积电3D Fabric技术平台该平台包含了台积电前端芯片堆叠SoIC技术和后端先进封装CoWoS和InFO技术。
SoIC技术有CoW(Chip on Wafer)和WoW(Wafer on Wafer)两种键合方式。根据互连方式的不同,InFO可以分为InFO-R和InFO-L两种;CoWoS则可以分为CoWoS-S、CoWoS-R和CoWoS-L三类。
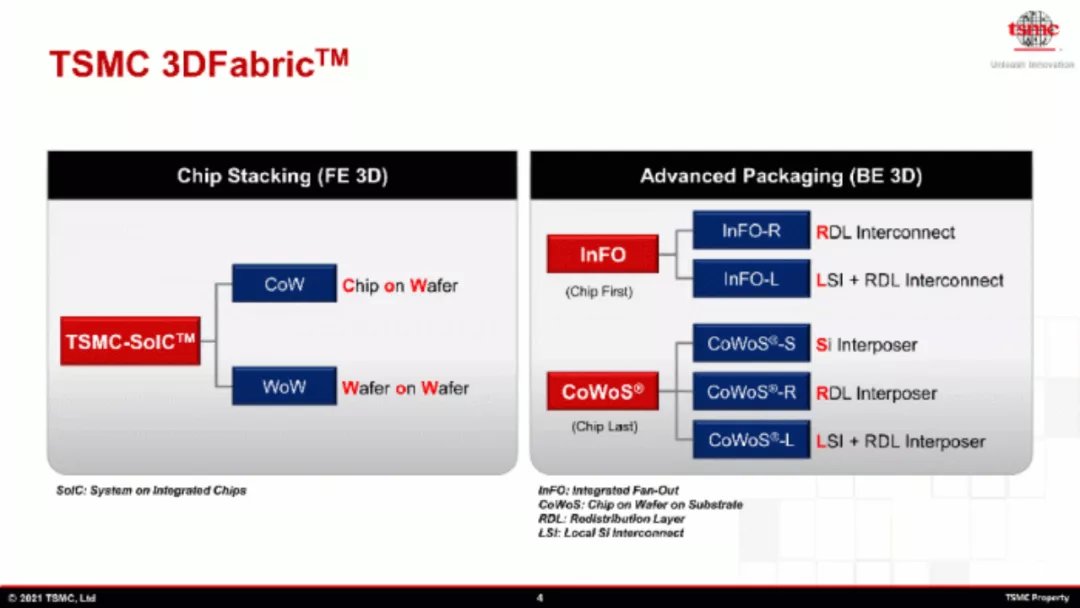
文章插图
随着时间发展,台积电的先进封装技术也会从InFO和CoWoS变为SoIC和InFO、CoWoS相结合。
台积电计划在2021年花费大约25至28亿美元的资本支出,以配备基于 InFO的设备、CoWoS和基于SoIC的产品线的新先进封装工厂。
- 常州承芯半导体有限公司|芯片布局再落一子,小米入股常州承芯半导体
- 芯片|斥资3.4亿美元 英特尔抢订ASML最先进光刻机
- 微信红包|芯片、汽车生产在恢复,芯片短缺问题即将解决?工信部回应
- 批发价低至 0.7 美元,树莓派宣布可批量购买 RP2040 芯片
- 芯片|从5488元降至2188元,曲面屏+7nm麒麟芯片+鸿蒙系统,终于等到了
- 芯片|厂商更爱高通:OPPO旗舰机不用天玑9000,骁龙8搭自研芯片
- 西方国家|一台就卖2000万,制造高端芯片的必要装备,中国已经做出来了
- IDM|英特尔再发声: “不要浪费芯片危机”,IDM巨头释放积极扩产信号
- 芯片|一家日本味精公司,却卡住了全球芯片企业的脖子,真的假的?
- 电子时报|台积电被爆再提高芯片价格!CPU和显卡售价将继续上涨
